
光刻是語(yǔ)音芯片生產(chǎn)制造的核心技術(shù)語(yǔ)音IC的更新?lián)Q代依賴于光刻技術(shù)的發(fā)展,必須針對(duì)每一世代的語(yǔ)音芯片技術(shù)開(kāi)發(fā)固有的光刻技術(shù)。想走在語(yǔ)音芯片市場(chǎng)的前列。研究探索新一代光刻技術(shù)是重中之重。而以往常用的100nm光刻技術(shù)也在時(shí)代的更替中推出歷史舞臺(tái)。
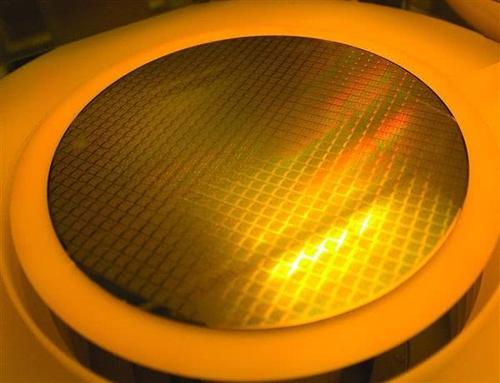
目前光學(xué)光刻方法已從接觸-接近式、反射投影式、步進(jìn)投影式發(fā)展到步進(jìn)掃描投影式,光源波長(zhǎng)已從436nm和365nm(汞弧燈)縮短到248nm(KrF準(zhǔn)分子激光源)。通過(guò)對(duì)光源、透鏡系統(tǒng)、精密對(duì)準(zhǔn)、光刻膠以及相移掩模(PSM)技術(shù)等方面長(zhǎng)期深入的研究工作,光學(xué)光刻方法取得了令人難以置信的進(jìn)展,可以突破通常的物理限制在芯片上印制出特征尺寸比光源波長(zhǎng)更小的圖形。去年投入生產(chǎn)的180nm技術(shù)采用了波長(zhǎng)248nm的步進(jìn)掃描投影光刻技術(shù)。對(duì)特征尺寸130nm的光刻技術(shù)將仍然用光學(xué)方法,目前正在開(kāi)發(fā)兩種技術(shù),一種是采用波長(zhǎng)248nm加PSM技術(shù),別一種是采用波長(zhǎng)193nm(ArF準(zhǔn)分子激光源)的光刻技術(shù)。
然而,一般認(rèn)為,利用光學(xué)光刻方法印制微細(xì)圖形已接近極限。在50nm及其以下,光學(xué)光刻方法將被其他新技術(shù)所取代。目前正在開(kāi)發(fā)的技術(shù)有電子投影光刻技術(shù)(EPL)、離子投影光刻技術(shù)(IPL)、X-射線光刻技術(shù)、電子束直寫(xiě)光刻技術(shù)(EBDW)以及超紫外(EUV)光刻技術(shù)等。至于對(duì)特征尺寸在100nm~70nm范圍內(nèi)則尚無(wú)定論,一般認(rèn)為光學(xué)光刻方法仍將與上述新技術(shù)相競(jìng)爭(zhēng)。